
近日,2018國際電子器件大會(IEDM)在美國舊金山召開。會上,微電子所劉明院士科研團(tuán)隊(duì)展示了28納米嵌入式阻變存儲器可靠性優(yōu)化以及基于HfZrO鐵電FinFET器件的最新研究成果。
對于新型存儲器RRAM,初始電形成過程會增加電路設(shè)計(jì)復(fù)雜度,帶來可靠性問題,一直是工業(yè)界和科研界研究的熱點(diǎn)。劉明院士團(tuán)隊(duì)在RRAM方向的研究具有豐富的經(jīng)驗(yàn),針對28納米的1Mb RRAM測試芯片(IEDM 2017 2.4.1),提出了高溫forming的編程方法,可以將平均forming電壓從2.5V以上降為1.7V。由于高溫forming過程中細(xì)絲內(nèi)殘留的氧離子大幅減少,編程之后由于氧離子和氧空位復(fù)合造成的電阻弛豫效應(yīng)得到消除,器件的保持特性得到了40以上的大幅提升。
 針對先進(jìn)工藝節(jié)點(diǎn)的嵌入式存儲器缺失問題,劉明院士團(tuán)隊(duì)與殷華湘研究員合作提出了基于HZO鐵電FinFET的混合存儲器件。該器件在電荷俘獲模式下,表現(xiàn)出高耐久性(>1012),高操作速度(<20ns),良好的數(shù)據(jù)保持特性(104@85oC),與DRAM的性能相近,為在SOC芯片及CPU芯片中集成嵌入式DRAM提供了可能。當(dāng)器件工作在電籌翻轉(zhuǎn)模式下的時(shí)候,器件表現(xiàn)出非常好的數(shù)據(jù)保持特性(>10年)以及對讀取信號串?dāng)_的免疫能力,使該器件同時(shí)具有優(yōu)越的不揮發(fā)存儲特性。
針對先進(jìn)工藝節(jié)點(diǎn)的嵌入式存儲器缺失問題,劉明院士團(tuán)隊(duì)與殷華湘研究員合作提出了基于HZO鐵電FinFET的混合存儲器件。該器件在電荷俘獲模式下,表現(xiàn)出高耐久性(>1012),高操作速度(<20ns),良好的數(shù)據(jù)保持特性(104@85oC),與DRAM的性能相近,為在SOC芯片及CPU芯片中集成嵌入式DRAM提供了可能。當(dāng)器件工作在電籌翻轉(zhuǎn)模式下的時(shí)候,器件表現(xiàn)出非常好的數(shù)據(jù)保持特性(>10年)以及對讀取信號串?dāng)_的免疫能力,使該器件同時(shí)具有優(yōu)越的不揮發(fā)存儲特性。
基于上述成果的2篇研究論文入選2018國際電子器件大會。第一作者許曉欣博士、羅慶博士分別在大會上作了口頭報(bào)告。 兩篇論文的通訊作者均為呂杭炳研究員和劉明院士。
IEEE國際電子器件大會始于1954年,現(xiàn)已成為全球報(bào)道半導(dǎo)體及電子領(lǐng)域最新的科技、研發(fā)設(shè)計(jì)、制造、物理學(xué)及建模技術(shù)的主要論壇,旨在為產(chǎn)學(xué)研界的研究學(xué)者提供關(guān)于電子器件最新研究進(jìn)展和研究成果的國際交流平臺。
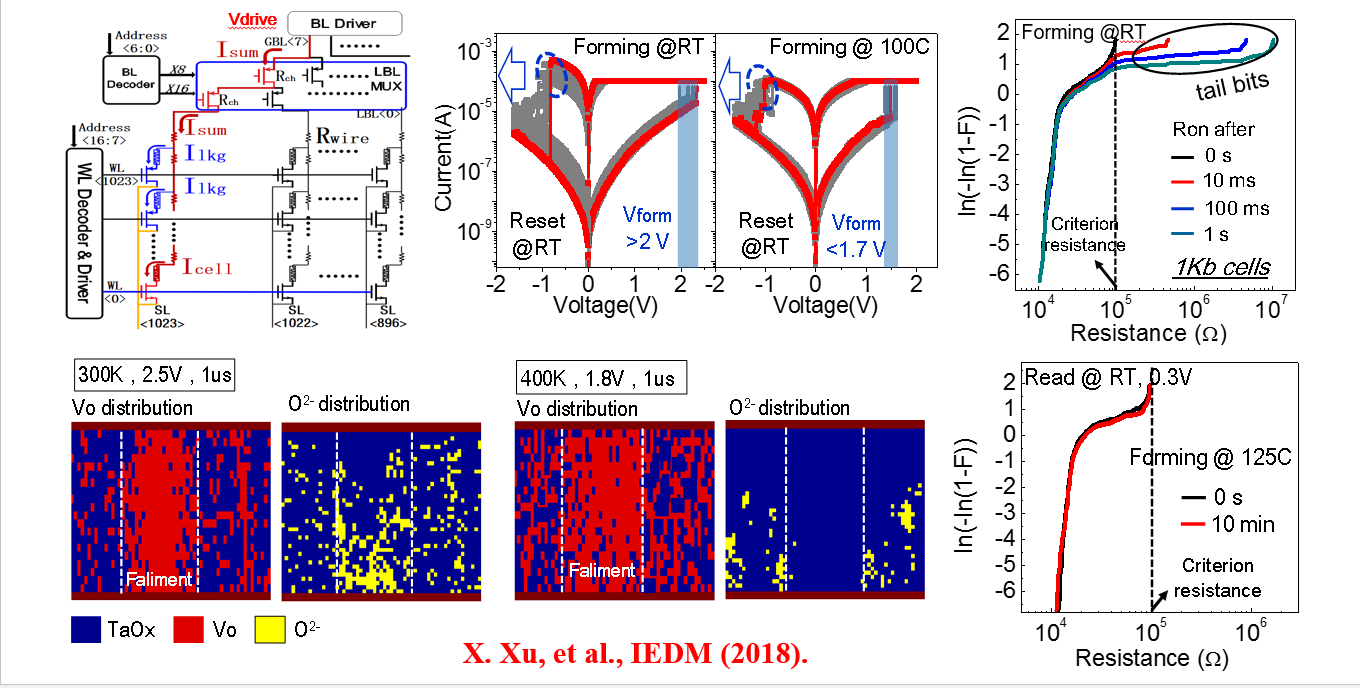
圖1. 28納米 RRAM測試芯片中采用高溫forming的測試方法,將器件的forming電壓降低至1.7V以下,顯著提升了存儲陣列的良率與可靠性
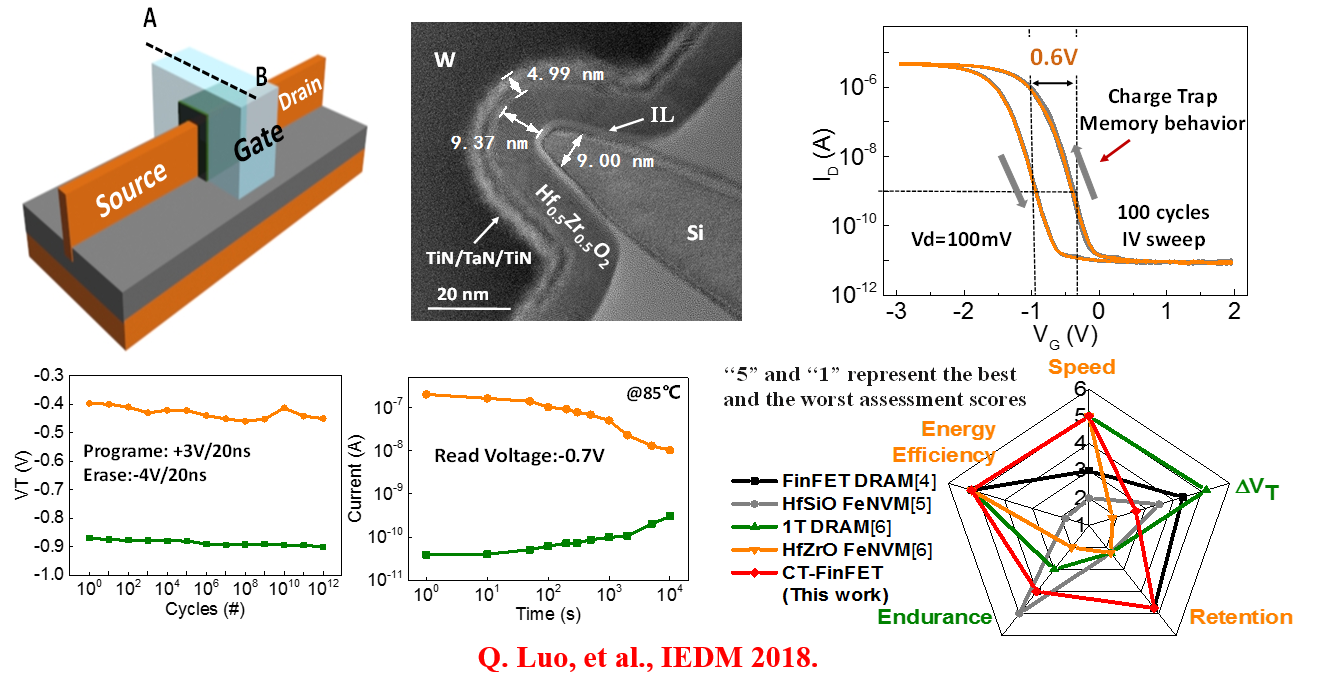
圖2. 基于HfZrO2鐵電材料的Finfet結(jié)構(gòu)1T DRAM,實(shí)現(xiàn)了1012以上20ns量級的快速擦寫,以及85度下104秒的長時(shí)間保持,為在CPU中嵌入百兆級別的大緩存提供了新途徑
集成電路創(chuàng)新技術(shù)