
近日,微電子所新技術開發部微系統技術實驗室焦斌斌研究員團隊在高密度低應力硅通孔(TSV)研究方面取得新進展。
三維(3D)集成技術是制造低功耗、高性能和高集成密度器件的必備技術,有望突破摩爾定律限制。TSV作為3D集成的核心技術,具有縮短互連路徑和減小封裝尺寸的優勢。目前,高密度TSV互連在近傳感器和傳感器內計算、混合存儲器立方體、高帶寬存儲器(HBM)、互補金屬氧化物半導體(CMOS)圖像傳感器、制冷和非制冷焦平面陣列、有源像素傳感器等具有重要應用前景。但在高密度應用場景下,由于硅襯底與TSV互連金屬之間熱膨脹系數不匹配,TSV存在嚴重的熱應力問題,會導致晶體管遷移率和參數偏移進而影響器件性能,甚至導致器件損壞,亟需通過結構調控抑制熱應力對器件可靠性的影響。
焦斌斌團隊創新性提出了兩端窄中間寬、兩端封閉中間空心的“類橄欖球”狀TSV結構,具有小孔徑、高深寬比、低應力等特點。向內潰縮的應力緩沖空心結構為TSV提供了應力釋放空間,可大幅降低襯底硅的應力和電遷移,可耐受大溫差使用工況,兩端封口結構兼容后續傳統旋涂涂膠工藝,具有普適性。目前已實現了國際已有報道中深度最大(>100μm)、深寬比最大(>20.3:1),殘余應力最小(31.02MPa)的TSV結構,其直徑5μm、中心距 25μm、TSV數量達320000(密度1600個/mm2),有效連通率達100%,是唯一可耐受極低溫工況(-200℃)的TSV解決方案。
基于該成果的論文“Low-Stress TSV Arrays for High-Density Interconnection”近期發表在中國工程院院刊Engineering(2095-8099,2095-8099,https://doi.org/10.1016/j.eng.2023.11.023)。微電子所焦斌斌研究員為論文第一作者兼通訊作者,喬靖評博士為論文第二作者。該研究成果同時被2023 IEEE 73rd Electronic Components and Technology Conference (ECTC)會議收錄,并以分會場報告的形式展示。
Engineering期刊瞄準世界科技前沿,服務國家重大戰略需求,面向人民生命健康,聚焦具有重大經濟、社會意義和世界先進水平的工程科技原創性成果,內容涉及全球重大挑戰、人工智能、新冠病毒肺炎、碳中和、6G等工程科技前沿熱點,引領工程科技各前沿領域的發展。
Electronic Components and Technology Conference (ECTC)是匯聚封裝、元件和微電子系統科學、技術和教育領域最佳合作與技術交流環境的頂級國際盛會。
論文鏈接:https://www.sciencedirect.com/science/article/pii/S209580992400153X
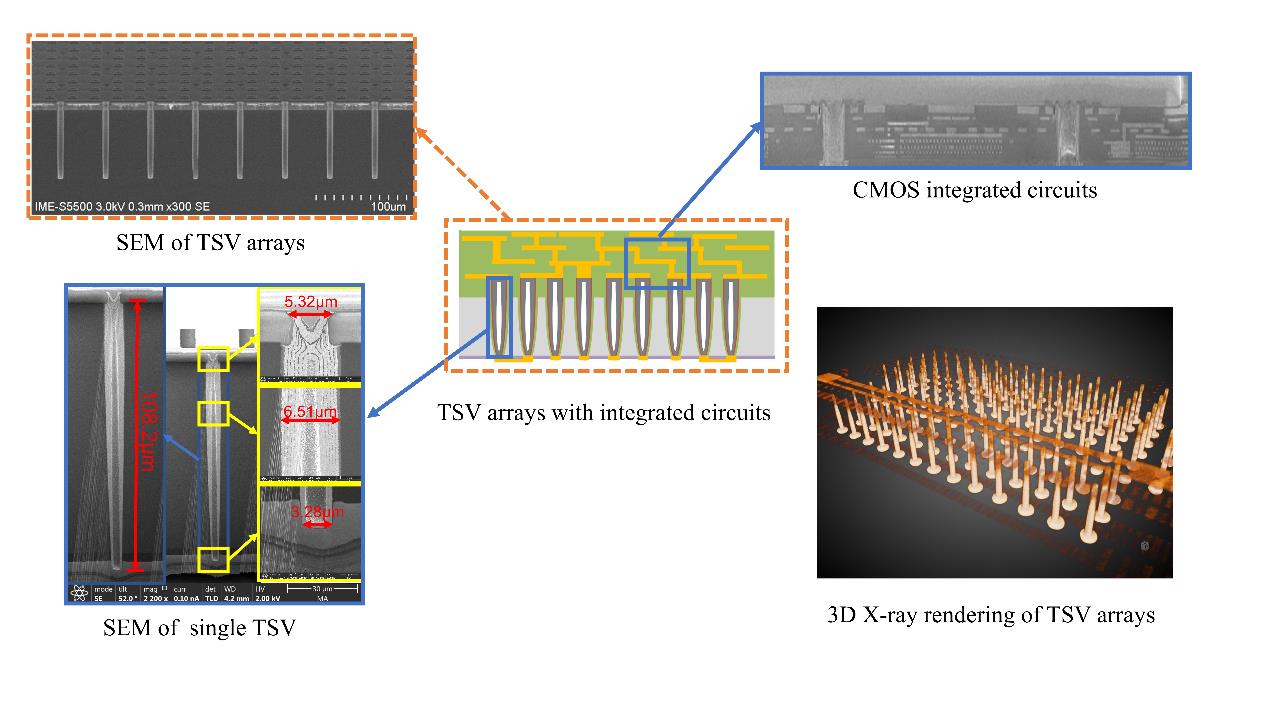

高密度互連的低應力TSV設計與制備
| 相關新聞: |
| 微電子所在光刻膠模型校準研究方面取得重要進展 |
| 微電子所在片上學習存算一體芯片方面取得重要進展 |
| 微電子所在數模混合存算一體芯片方面取得重要進展 |
綜合新聞