
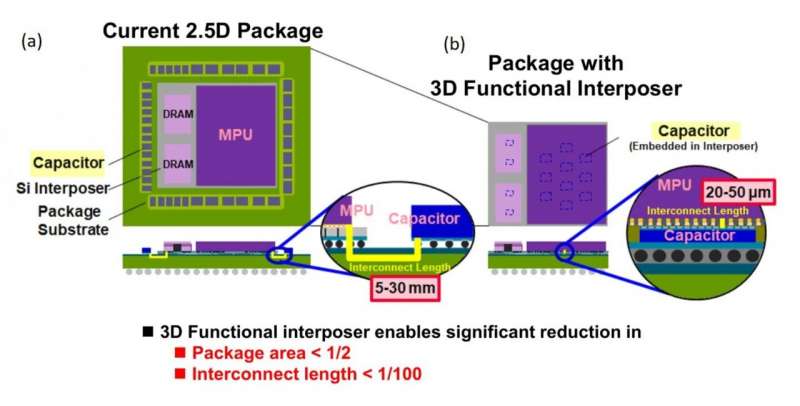
東京工業(yè)大學(xué)的科學(xué)家們開發(fā)了一種 3D 功能中介層,即芯片和封裝基板之間的接口,在此可嵌入電容器。這種緊湊的設(shè)計節(jié)省了大量的封裝面積,并大大減少了芯片端子和電容器之間的布線長度,降低了噪聲和功耗,這項技術(shù)為更小型化的新型半導(dǎo)體封裝結(jié)構(gòu)鋪平了道路。
電子產(chǎn)品開始時尺寸很大,但隨著時間的推移和技術(shù)的革新發(fā)展,尺寸逐漸減小、緊湊。例如今天智能手機,其性能19世紀80 年代的計算機高出幾個等級。不幸的是,如今使用的材料和設(shè)計已經(jīng)接近其物理極限,這種性能和規(guī)模的發(fā)展趨勢必然會大大減緩。為了克服這些問題,關(guān)鍵是要提出新的想法,來解決技術(shù)瓶頸問題。
在過去十年中,用于電子產(chǎn)品的無源元件電容器的發(fā)展在某些方面停滯不前。雖然現(xiàn)在可制造的電容器比以往更小,但它們的單位面積實際容量并沒有提高多少,我們需要一種技術(shù)在減少使電容器占用空間的同時,更保持其性能。
日本東京工業(yè)大學(xué)Takayuki Ohba 教授領(lǐng)導(dǎo)的研究人員致力于開發(fā)這種技術(shù)以維持半導(dǎo)體電路的規(guī)模化。該團隊將在《 2021 年 IEEE 電子元件和技術(shù)會議論文集》上發(fā)表的最新的研究成果顯示,利用硅中介層(將集成芯片與電路封裝或其他芯片保持并垂直連接的平面接口,可以制成功能電容器,省了大量空間,帶來了巨大的效益。
在2.5D封裝中,諸如 DRAM 和微處理器之類的芯片位于具有硅通孔的中介層頂部,垂直導(dǎo)電隧道將芯片中的連接與封裝基板上的焊料凸塊連接起來。電容器放置在靠近它們所服務(wù)的組件的封裝基板上,并且必須在它們的端子和芯片端子之間進行連接,跨度為5-30毫米。這種布局不僅增加了封裝基板面積,而且較長的互連會導(dǎo)致高布線電阻和噪聲等問題。
與這種設(shè)計不同的是,東京理工的團隊直接把中介層做成了硅電容,通過一種新穎的制造工藝實現(xiàn)了這一點,其中使用永久性粘合劑和模制樹脂將電容元件嵌入到 300 毫米的硅片中。芯片和電容器之間的互連直接通過硅通孔制成,無需焊料凸點。研究人員表示該無擾動 3D 功能性中介層將封裝面積減少了約 50%,互連長度甚至縮短了100 倍。
研究人員還設(shè)法巧妙地避免了無凸塊晶圓上芯片設(shè)計的兩個最常見問題,即樹脂導(dǎo)致的晶圓翹曲,粘合劑中的空隙袋導(dǎo)致的錯位錯誤。通過測試和理論計算,研究人員發(fā)現(xiàn)功能性中介層降低了布線電阻和寄生電容,從而降低功耗。
| 相關(guān)新聞: |
| 大連化物所等在柔性電子用微型超級電容器驅(qū)動的集成系統(tǒng)研究中獲進展 |
| 電工所等開發(fā)出高比能柔性固態(tài)鋰離子電容器制備技術(shù) |
| 合肥研究院在超高儲能密度超級電容器研制方面取得進展 |
學(xué)習(xí)園地