
隨著移動通信、衛(wèi)星通信、雷達等大功率應(yīng)用環(huán)境的快速發(fā)展,氮化鎵高電子遷移率晶體管(HEMT)已成為高頻、高功率及惡劣環(huán)境下的核心器件之一。但器件功率密度和工作電壓得不斷攀升,器件自熱問題日益突出,傳統(tǒng)單晶Si或SiC襯底在散熱能力方面愈發(fā)難以滿足需求。利用高熱導率金剛石構(gòu)建高效散熱襯底,被認為是解決GaN器件自熱、提升可靠性和功率性能的理想路徑。
近日,微電子所劉新宇研究員團隊與青禾晶元公司、南京電子器件研究所等單位團隊合作,基于4H-SiC/Diamond復合襯底成功實現(xiàn)了高散熱性能的GaN HEMT器件,為突破GaN器件散熱瓶頸提供了新的技術(shù)方案。
針對GaN與Diamond之間嚴重應(yīng)力和熱失配問題,團隊在常規(guī)金剛石襯底表面引入一層4H-SiC薄膜用于高溫GaN外延過程中緩解晶格失配和熱膨脹失配。該方案創(chuàng)新采用基于表面活化鍵合(SAB)的薄膜二次轉(zhuǎn)移技術(shù),將厚度約784 nm的4H-SiC薄膜鍵合轉(zhuǎn)移到金剛石襯底上,可耐受超過1100℃的高溫,并在此基板上制備出GaN HEMT器件。該工藝實現(xiàn)了最高可達98%的鍵合率,轉(zhuǎn)移后4H-SiC薄膜的XRD搖擺曲線半高寬與體SiC相當,表明薄膜保持了接近本征的晶體質(zhì)量。經(jīng)過900 ℃高溫退火處理,4H-SiC/Diamond界面熱阻進一步降低至13.6 m2·K/GW,是目前國內(nèi)外已報道4H-SiC/Diamond界面熱阻中的最優(yōu)水平,該結(jié)果與退火過程中非晶中間層的消失及局部重結(jié)晶密切相關(guān)。基于紅外熱成像穩(wěn)態(tài)測試環(huán)境(基板溫度70℃)測試了功耗高達32.5 W/mm條件下的器件結(jié)溫。與同批次工藝同規(guī)格SiC襯底器件相比,SiC/Diamond復合襯底上GaN HEMT器件熱阻降低了61.4%;在23.4 W/mm的工作條件下,其結(jié)溫降低40.5 ℃。上述試驗結(jié)果表明,4H-SiC/Diamond復合襯底能夠在保持工藝兼容性的同時可顯著提升器件散熱能力,在高微波功率器件應(yīng)用方面展現(xiàn)出廣闊的應(yīng)用前景。
上述研究成果以 “GaN HEMTs on 4H-SiC/Diamond Engineered Substrate with Enhanced Heat Dissipation”(doi:?10.1109/LED.2025.3635043)為題,近期發(fā)表在?IEEE Electron Device Letters。微電子所博士生雷依培為第一作者,微電子所王鑫華研究員為論文通訊作者。
論文鏈接:https://ieeexplore.ieee.org/document/11260442
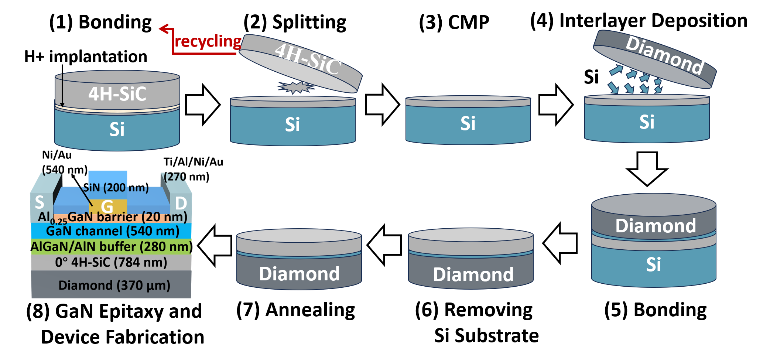
圖1?基于4H-SiC /Diamond襯底的GaN HEMT制備流程

圖2 (a) SiC/Diamond界面熱阻隨退火溫度的變化;(b)?基于不同襯底(SiC?與?SiC/Diamond復合襯底)GaN HEMT?結(jié)溫隨耗散功率密度的變化。
| 相關(guān)新聞: |
| 微電子所在RRAM存算一體芯片研究方面取得進展 |
| 微電子所在GaN外延位錯傳導載流子及其導致功率電子器件可靠性退化機制取得重要進展 |
| 微電子所在大模型神經(jīng)網(wǎng)絡(luò)注意力加速器研究上取得進展 |
綜合新聞