
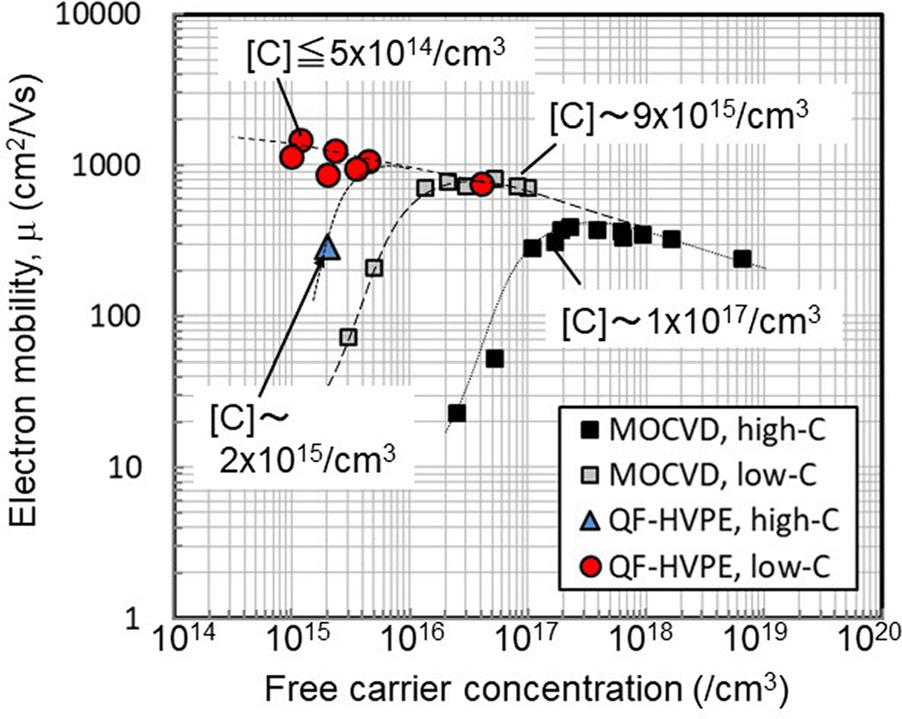
日本SCIOCS Co Ltd宣稱其n型氮化鎵(n-GaN)在室溫下具有最高的遷移率,載流子密度為1015/cm3。這種低摻雜層是額定電壓高達(dá)10kV的垂直功率器件的關(guān)鍵組件,需要厚漂移層以減少電場,同時保持導(dǎo)電率,與遷移率和自由載流子密度成比例。
SCOICS團(tuán)隊使用氫化物氣相外延(HVPE),該采用金屬鎵和氨(NH3)作為原料,避免了C的存在,從而避免了碳污染有關(guān)的遷移率崩潰效應(yīng)。HVPE的另一個優(yōu)勢是,其生長速度比MOCVD快得多。
為了能夠精確控制低電子密度材料所需的硅摻雜,研究人員開發(fā)了一種QF-HVPE工藝。QF-HVPE的增長是通過從設(shè)備的高溫區(qū)域去除石英來實現(xiàn)的,并且避免了氧污染。溫度為1050°C,基板為2英寸,+c取向,Si摻雜的n型自立式GaN,采用SiCOSCS開發(fā)的空穴輔助分離法生產(chǎn),QF-HVPE的增長率約為1μm/min。
在低 QF-HVPE工藝中發(fā)現(xiàn)了最高的遷移率1470cm2/V-s,其自由電子密度非常低,僅為1.2x1015/cm3。這是迄今為止GaN晶體報道的最高室溫遷移率。
該團(tuán)隊還測量了通過MOCVD和QF-HVPE生長的晶片上的載流子密度均勻性)。平均載流子密度分別為7x1015/cm3和3.4x1015/cm3。MOCVD中載流子密度的不均勻性的標(biāo)準(zhǔn)偏差為16.7%。這歸因于斜角依賴的C摻入效率。對于QF-HVPE,不均勻性標(biāo)準(zhǔn)偏差是已經(jīng)很低的平均載流子密度的4.0%。
QF-HVPE n-GaN的光致發(fā)光研究顯示,清晰的363nm波長近帶邊緣發(fā)射峰,以及以520-530nm為中心的較弱的寬綠色發(fā)射。這種綠色發(fā)光與氮空位有關(guān)。沒有黃色發(fā)光的跡象,通常是由于C污染引起的。
| 相關(guān)新聞: |
| GaN和SiC功率半導(dǎo)體市場不斷發(fā)展 |
| 改善氮化鎵μ發(fā)光二極管的MOCVD隧道結(jié) |
| 具有導(dǎo)電底鏡和觸點的氮化鎵VCSEL |
綜合新聞