
近些年來,中國大力發展的大數據、云計算、人工智能、量子技術以及諸多大科學裝置是依賴于信息的快速獲取、高速處理和高效傳輸,實現這一切的基礎則是需要有性能更為強大的元器件作為保障。然而,傳統的硅集成電路在數據的處理速度和帶寬等性能上已越來越無法滿足日益增長的需求。為此,人們一直通過不斷提高提高微電子芯片的集成度來解決相關問題,目前, ASML EUV 光刻系統可實現 7 nm節點甚至更小尺度的晶體管制造,但隨著器件特征尺度的不斷減小,傳統晶體管在速度、功耗、集成度、可靠性等方面受到一系列基本物理問題和工藝技術的限制,為此,一方面將高遷移率“非硅”材料引入到 Si 基 CMOS 技術中,成為下一代邏輯芯片的必要選擇;另一方面在Si 基實現光子器件與電子器件在硅晶片上集成,即將CMOS兼容的激光、光調制器、光波導、光探測器等器件集成到微電子電路中,稱為硅基光電子集成[1]。在CMOS 技術研究中,III-V 族半導體具有很高的電子遷移率(GaAs、InAs 的電子遷移率分別可達到 9000cm2/(V·s)、40000cm2/(V·s)),它們在低場和高場下都具有優異的電子輸運性能,是超高速、低功耗 nMOS 的理想溝道材料, 而鍺材料以其較高的低電場空穴遷移率,是作為 PMOS 器件溝道的理想材料。圖1表展示了典型的元素和化合物半導體材料的遷移率數據[2]。可以看出,Ge具有較高的空穴遷移率,III-V復合半導體材料(GaP除外)比Si具有更高的電子能動性,在硅襯底上實現 III-V 族材料與鍺材料的單片集成,并進一步制備 CMOS 器件,可以極大的提高邏輯芯片的性能。
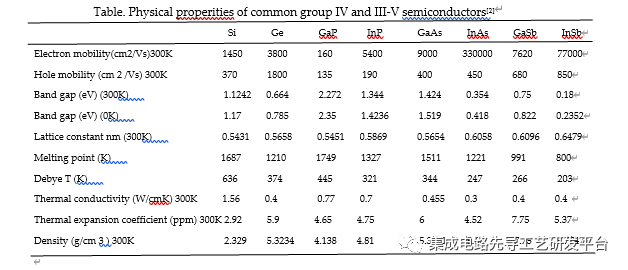
Ge/III-V與Si CMOS平臺的異構集成是實現7 nm及以下技術節點的超低功耗集成系統的一個很有前途的方向,如下圖1所示[3]。
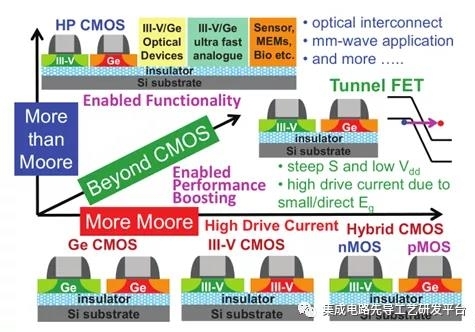
圖1:Si平臺Ge/III-V器件異質集成的發展趨勢
在硅基光子與微電子器件集成方面,最大的困難是實現光源(包括激光器和放大器)在硅襯底上的集成。由于Si是間接帶隙半導體材料,其發光效率很低;III-V化合物半導體是直接帶隙材料,能夠高效發光,在Si基上異質集成 III-V 材料并實現 Si 基光源,將會進一步推進硅基光互聯的快速發展。Ⅲ-Ⅴ化合物特別是砷化鎵(GaAs)、磷化銦(InP)等,天然是直接帶隙材料,其價帶頂和導帶底位于波矢 k 空間中同一位置,電子、空穴復合無需交換動量,因此具有很高的內量子效率[4]。并且其二者及其固溶物 InGaAsP、InGaAlAs 等正好覆蓋光通信常用的 O 波段(1260 nm-1360 nm,中心為 1310 nm)與 C+L 波段(C 波段:1530 nm-1565nm,中心為 1550 nm;L 波段:1565 nm-1625nm)。由化合物半導體制作的半導體激光器,構成了如今光網絡中光發射模塊的核心部件——目前高速直調激光器速率已超過 50 Gbit/s[5];可調諧激光器能在邊模抑制比達到 40 dB 的同時,調諧范圍大于 30 nm、甚至可達 40 nm 以上[6];下一步正在開發新一代速率 400 Gbit/s 的傳輸標準。如圖2所示[7],開發出的硅基量子點激光器示意圖,工作溫度達到100℃,激光器激射波長延伸到 1310 nm 附近,可靠性也得到了很大提升。
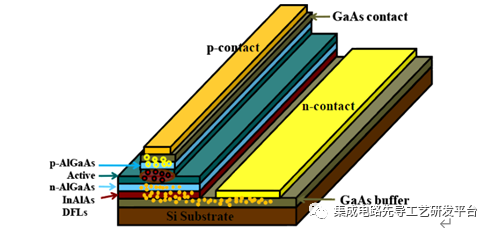
圖2:硅基異質集成III-V族量子點激光器結構示意圖
實現硅基上異質集成 III-V 材料,直接外延與鍵合是目前兩種主流的解決方案。晶圓鍵合是指在晶圓的兩個表面涂上一層玻璃薄膜,然后在薄膜軟化溫度下將兩層表面壓在一起,在高溫下將兩層固體“粘”在一起。圖3是目前用于將GaAs膜或更復雜的HS(例如激光結構)轉通過鍵合移到大塊硅襯底上的過程示意圖[8]。
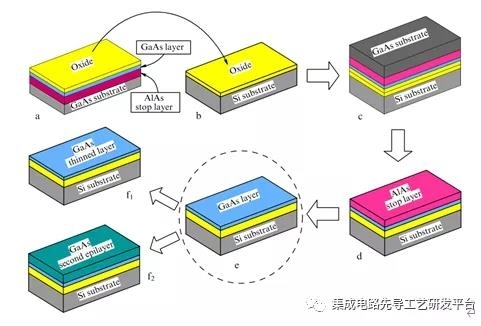
圖3:晶片鍵合法制造GaAs/Si基底的原理圖[8]
在硅上直接外延三五族化合物半導體是最直接的一種方法,然而硅和III-V族化合物半導體材料的晶格失配很大(硅與 GaAs、 InP的失配分別為 4 %和 8 %),在硅上外延III-V族半導體材料會在材料內導致應變的產生。另外,硅是非極性晶體,而III-V族半導體是極性晶體,當兩者結合時會在界面處產生反相疇。因此,如果控制不好生長條件,會導致材料內存在較大應力,以及較大的成核尺寸導致的表面粗糙,這些都影響著硅上外延III-V族半導體材料的質量和器件的性能。圖4為一些半導體材料,以及它們相應的電子特性,如BG和晶格常數差異等。
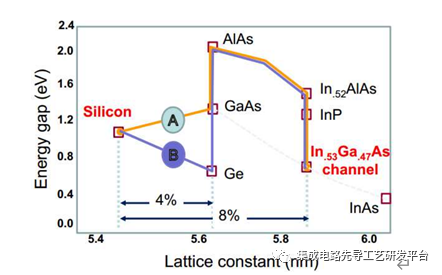
圖4:V族與III-V半導體的能隙與晶格常數差異
在面對硅基 III-V 族材料異質外延中晶格失配、熱失配導致的失配位錯,以及極性半導體在非極性半導體上外延時產生的反相疇及反相疇邊界問題時,獲得高質量的III-V半導體材料外延層,直接決定了半導體光電器件的性能,圖5為硅基 III-V族材料異質外延的現狀及主要挑戰。
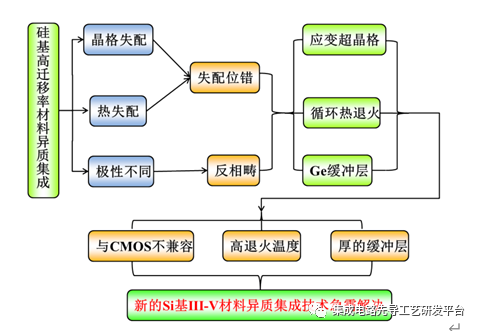
圖5:硅基 III-V族材料異質外延的現狀及主要挑戰
為了解決這些問題,通常引入緩沖層來減小III-V族半導體在硅上生長帶來的缺陷密度比如,Ge 與 GaAs 的失配為 0.08 %,熱膨脹系數也比較接近,因此,通過 Ge 緩沖層在硅上可以外延 GaAs,并可在此基礎上外延其他III-V族材料。為了抑制反相疇,可使用有一定偏角的硅襯底并在 V 族元素氣體中高溫預處理襯底,通過這種方法在硅襯底上形成雙原子臺階并實現表面重構,能夠抑制了反相疇。近日,中科院微電子所集成電路先導工藝研發中心Henry Radamson研究員課題組在先導中心平臺上成功研制了8寸的GaAs晶圓,其表面無反向疇缺陷,表面粗糙度小于1nm,得到了所長基金和中國科學院創新研究院的支持。該成果將為下一步開展InGaAs/InP、InGaP等光電器件提供良好的外延層材料基礎。
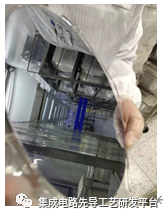
圖6:先導中心8寸平臺上制備的8-inch GaAs晶圓
[1]Wang Ting, Zhang Jian-jun, Liu Hui-yun,Quantum dot lasers on silicon substrate forsilicon photonic integration and their prospect[J],ActaPhy.Sin.Vol.64,No.20(2015)
[2] O.Madelung, Semiconductors: Data Handbook (Springer, 2004)
[3]Shinichi Takagi and Mitsuru Takenaka,Ge/III-VMOS Device Technologies for Low Power Integrated Systems,Europeansolid state device research conference 2015, pp20-25
[4]SRINIVASANS, LIU A, LIANG D et al. Lasers (Emitters) and Amplifiers on Silicon[M], VENGHAUSH, GROTE N.. Fibre Optic Communication: Key Devices. Springer.
[5]MATSUI Y,PHAM T, SUDO T et al. 112-Gb/s WDM link using two Directly Modulated Al-MQW BHDFB Lasers at 56 Gb/s[J]. Optical Fiber Communication Conference Post DeadlinePapers, 2015.
[6]GOTODA M,NISHIMURA T, TOKUDA Y. Widely tunable SOA-integrated DBR laser with combinationof sampled-grating and superstructure grating[J]. 2004 IEEE 19th International SemiconductorLaser Conference, 2004
[7]A. Lee, Q.Jiang, M. Tang, et al.,“Continuous-wave InAs/GaAs quantum-dot laser diodesmonolithically grown on Si substrate with low threshold current densities,”Optics Express, vol.20, pp. 22181, 2012.
[8] Yu BBolkhovityanov, O P Pchelyakov. GaAs epitaxy on Si substrates: modern status ofresearch and engineering, 2008 Phys.-Usp. 51 437
| 相關新聞: |
| STT-MRAM器件與集成技術研究 |
| 微電子所先導中心準原子層刻蝕技術最新進展 |
| 微電子所在先進Co互連阻擋層研究領域取得進展 |
綜合新聞