
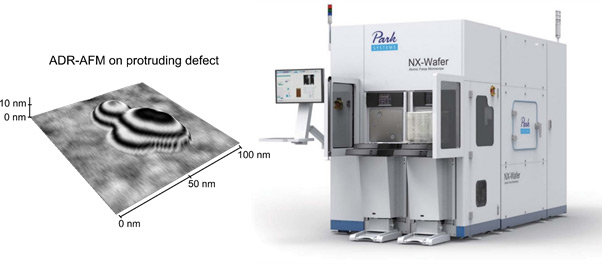
基于AFM的缺陷檢查的最大挑戰(zhàn)之一是將缺陷坐標(biāo)從AOI轉(zhuǎn)移到AFM。最初手動標(biāo)記的方法很耗時,并且顯著降低了吞吐量。另一方面,使用AFM進(jìn)行的自動缺陷檢查可從AOI數(shù)據(jù)中導(dǎo)入缺陷的坐標(biāo)。導(dǎo)入缺陷坐標(biāo)需要晶片的精確對準(zhǔn)以及AOI和AFM之間的平臺誤差補(bǔ)償。具有比AOI更高的位置精度的光學(xué)分析工具(例如candela)可以在快速的中間校準(zhǔn)步驟中減少載物臺誤差。ADR-AFM測量包括在給定缺陷坐標(biāo)處的大規(guī)模調(diào)查掃描,缺陷的高分辨率圖像以及缺陷分類。由于具有自動化功能,因此更加簡便,效率更高。為了維持納米范圍的筆尖半徑,并為后續(xù)掃描提供高分辨率,ADR-AFM使用了非接觸式動態(tài)成像模式,因此,ADR-AFM可以防止烙鐵頭磨損,并確保對缺陷進(jìn)行定量檢查。
比較AOI和ADR-AFM
研究人員比較了用AOI和ADR-AFM對相同納米尺寸缺陷進(jìn)行缺陷檢查的結(jié)果。雖然AOI根據(jù)散射光的強(qiáng)度估算缺陷的大小,但ADR-AFM可以通過機(jī)械掃描直接對缺陷成像,除橫向尺寸外,ADR-AFM還可以測量缺陷的高度或深度,從而可以區(qū)分突出的“凸點(diǎn)”和縮進(jìn)的“凹痕”缺陷。缺陷的三維形狀的可視化可確保可靠的缺陷分類,這是無法通過AOI實(shí)現(xiàn)的。
比較ADR-SEM和ADR-AFM
除了ADR-AFM,還可以使用ADR-SEM進(jìn)行高分辨率缺陷檢查。ADR-SEM通過SEM測量基于AOI數(shù)據(jù)的DOI坐標(biāo)進(jìn)行自動缺陷檢查,在此期間高能電子束掃描晶圓表面。盡管SEM具有較高的橫向分辨率,但通常無法提供有關(guān)缺陷的定量高度信息。
為了比較ADR-SEM和ADR-AFM的功能,首先通過ADR-SEM對晶片的相同區(qū)域進(jìn)行成像,然后再進(jìn)行ADR-AFM測量。由于ADR-AFM中ADR-SEM掃描區(qū)域的可見性,ADR-SEM遺漏了一個突出的缺陷。此外,具有高垂直分辨率的ADR-AFM表現(xiàn)出足夠的靈敏度來檢測高度低至0.5 nm的表面缺陷。由于缺乏垂直分辨率,這些缺陷無法通過ADR-SEM成像。ADR-SEM掃描區(qū)域可以在ADR-AFM圖像中識別為缺陷周圍的矩形。相比之下,無創(chuàng)成像和高垂直分辨率使ADR-AFM成為缺陷檢查的表征技術(shù)的理想之選。
結(jié)論
原子力顯微鏡測量的自動化簡化了缺陷表征中原子力顯微鏡的先前耗時的工作流程。AFM自動化的進(jìn)步是引入ADR-AFM的基礎(chǔ),其中可以從先前的AOI測量中導(dǎo)入缺陷坐標(biāo),并且隨后的基于AFM的表征不需要用戶在場。因此,ADR-AFM有資格作為一種在線方法進(jìn)行缺陷檢查。特別是對于一位或兩位數(shù)納米范圍內(nèi)的缺陷尺寸,ADR-AFM補(bǔ)充了傳統(tǒng)的AOI、AFM的高垂直分辨率有助于三維缺陷的分類。非接觸式測量模式可確保無創(chuàng)表面特征并防止AFM尖端磨損,從而確保在許多連續(xù)測量中均保持高分辨率。
學(xué)習(xí)園地