
Mo/Si多層膜的周期厚度約7.0nm,可用來提高光學器件的反射率。近原子精度的膜層厚度誤差會導致反射光譜的峰值波長偏移,因而準確表征Mo/Si多層膜薄膜厚度對工藝迭代和分析具有重要作用。在透射電鏡(TEM)表征時,需關注Si基底的晶向,或采用熔石英等非晶基底材料,以保證樣品截面相對電子束垂直,否則三維立體樣品的二維投影成像會產生偽影,造成測量誤差。???
近期,中國科學院上海光學精密機械研究所研究團隊,在透射電鏡精確表征納米薄膜研究方面取得進展。研究團隊提出了樣品沿β方向傾轉后測量薄膜厚度的計算公式,并給出了TEM精確表征納米薄膜結構的方法。
團隊以沉積在Si[100]基底的Mo/Si多層膜為例,通過TEM測量了多層膜在不同傾轉角度下的膜層結構。結果表明,樣品沿α方向傾轉時,因薄膜厚度方向始終與電子束垂直,電子束穿過的TEM樣品厚度增大,因而Mo層和Si層的測量厚度幾乎沒有變化,但界面粗糙度增大;樣品沿β方向傾轉時,因樣品截面與電子束不垂直,導致偽影嚴重,難以區(qū)分Mo層和Si層。進一步,團隊提出了樣品沿β方向傾轉后測量薄膜厚度的計算公式,并給出了TEM精確表征納米薄膜結構的方法,即從制樣開始,沿特定方向[1-10]切割Si wafer,再從[110]晶帶軸觀察樣品,可保證Si wafer和薄膜截面均與電子束垂直,并在TEM樣品較薄的區(qū)域拍照分析。
該技術一定程度上提高了TEM表征納米薄膜結構的準確性,對光學薄膜微觀結構影響及其性能研究具有重要意義。同時,該技術的進一步應用可指導光學薄膜工藝改進方向,助力光學薄膜研發(fā)。
相關研究成果發(fā)表在《光學學報》上。研究工作得到國家自然科學基金委員會的支持。
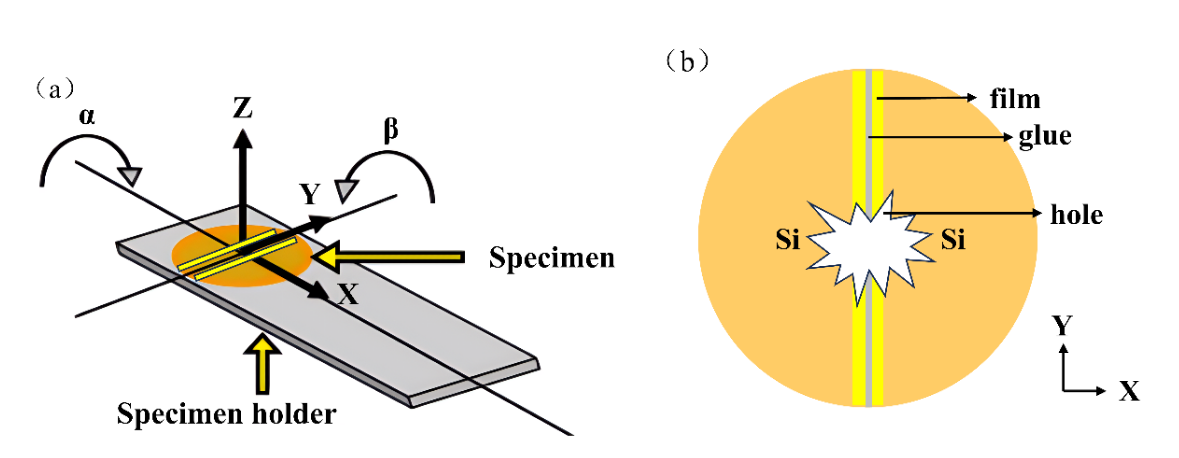
薄膜TEM截面樣品傾轉示意圖

相對誤差δ隨傾轉角度β變化的計算結果
| 相關新聞: |
| 物理所實現柔性碳納米薄膜的透明導電協(xié)同提升和大面積制備 |
| 物理所在碳納米管薄膜電學輸運性能與其手性結構的依存關系方面獲進展 |
| 蘇州納米所利用層狀化結構工程策略構筑高導電碳納米管氣凝膠薄膜 |
學習園地