
硅基氮化鎵橫向功率器件因其低比導(dǎo)通電阻、高電流密度、高擊穿電壓和高開關(guān)速度等特性,已成為下一代高密度電力系統(tǒng)的主流器件之一,并在電子消費產(chǎn)品中得到大規(guī)模應(yīng)用。由于硅基氮化鎵橫向功率器件電氣可靠性十分有限,主要表現(xiàn)在硬開關(guān)工作環(huán)境中的動態(tài)電阻退化效應(yīng),這給其在壽命要求較長的領(lǐng)域(如數(shù)據(jù)中心、基站等電源系統(tǒng))應(yīng)用帶來了挑戰(zhàn),阻礙了其在ICT電源等大功率領(lǐng)域中的大規(guī)模應(yīng)用。
提升硅基氮化鎵橫向功率器件可靠性的難點在于如何準(zhǔn)確測試出器件在長期高壓大電流應(yīng)力工作下的安全工作區(qū),如何保證器件在固定失效率下的壽命。硅基氮化鎵橫向功率器件在高壓大電流場景下的“可恢復(fù)退化”與“不可恢復(fù)退化”一直以來很難區(qū)分,這給器件安全工作區(qū)的識別和壽命評估帶來了極大的挑戰(zhàn)。針對上述問題,中科院微電子所劉新宇研究員團隊基于自主搭建的硅基氮化鎵橫向功率器件動態(tài)可靠性測試系統(tǒng),從物理角度提出了硅基氮化鎵橫向功率器件開關(guān)安全工作區(qū)的新定義及表征方法。該技術(shù)能夠表征硅基氮化鎵橫向功率器件開發(fā)中動態(tài)電阻增大的問題及其開發(fā)的硅基氮化鎵橫向功率器件對應(yīng)的材料缺陷問題。
上述研究成果以“Characterization of Electrical Switching Safe Operation Area On Schottky-Type p-GaN Gate HEMTs”為題發(fā)表在國際電力電子集成電路領(lǐng)域頂級期刊《IEEE Transactions on Power Electronics》上 (DOI: 10.1109/TPEL.2023.3265960)。高頻高壓中心博士生黃怡菲為文章第一作者,蔣其夢研究員為通訊作者。該工作得到了國家重點研發(fā)計劃、國家自然科學(xué)基金、中國科學(xué)院前沿科學(xué)重點研究項目以及北京市科委項目等項目的支持。
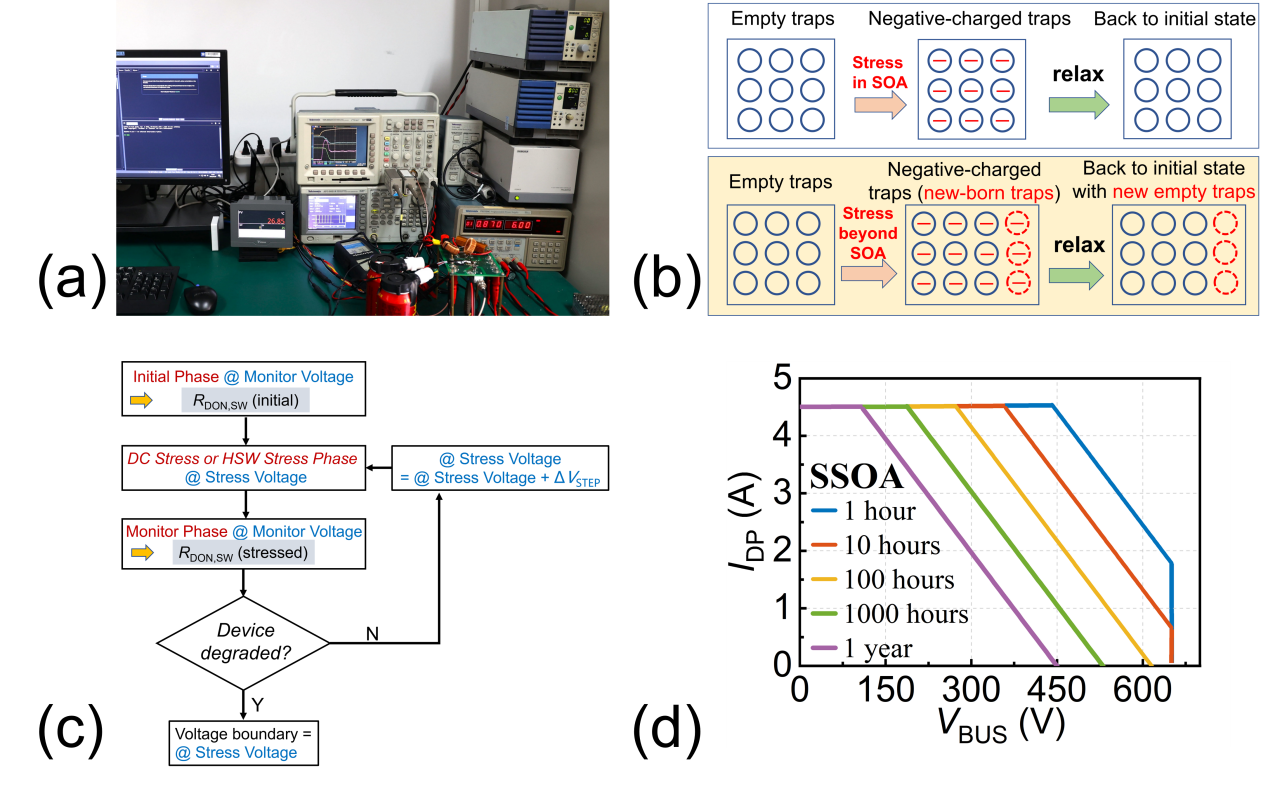
圖 (a) 團隊自主搭建的自動化硅基氮化鎵橫向功率器件動態(tài)可靠性研究平臺。(b) 基于器件是否生成新陷阱的角度區(qū)分硅基氮化鎵橫向功率器件的“可恢復(fù)退化”與“不可恢復(fù)退化”。(c) 提出一種檢測器件發(fā)生不可恢復(fù)退化的邊界的測試方法,以此測試序列表征器件開關(guān)安全工作區(qū)。(d) 所測試的硅基氮化鎵橫向功率器件的開關(guān)安全工作區(qū)。
| 相關(guān)新聞: |
| 微電子所在自旋神經(jīng)形態(tài)器件方面取得新進展 |
| 微電子所在半導(dǎo)體器件物理領(lǐng)域取得重要進展 |
| 微電子所在表面等離激元光纖生化傳感器方面取得重要進展 |
學(xué)習(xí)園地