
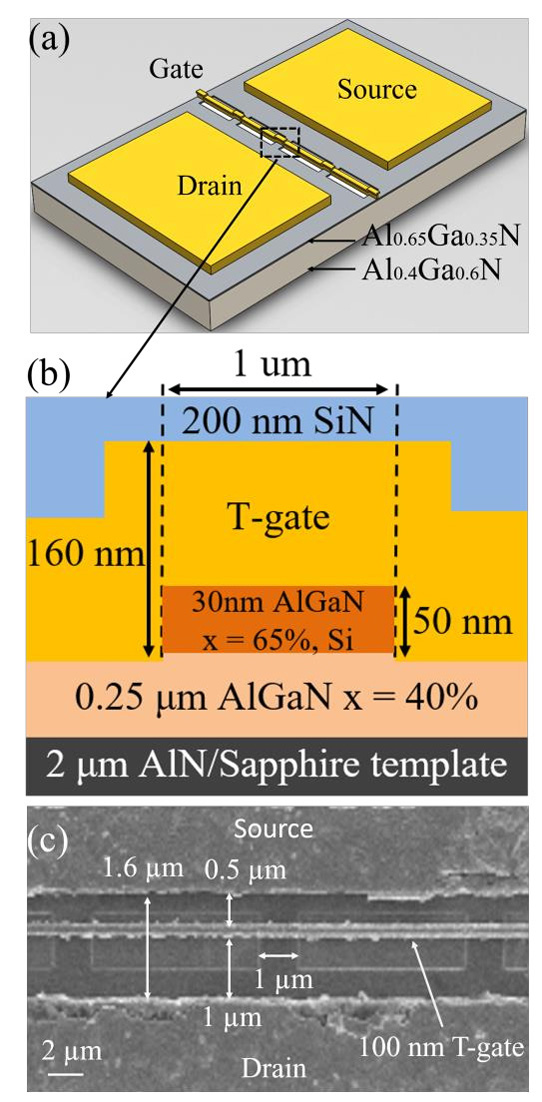
美國(guó)俄亥俄州立大學(xué)和南卡羅來(lái)納大學(xué)報(bào)告了富鋁氮化鋁鎵(AlGaN)溝道晶體管有史以來(lái)最高的射頻(RF)輸出~率密度為10GHz時(shí)為2.7W / mm。
研究人員使用了“微通道”異質(zhì)結(jié)構(gòu)場(chǎng)效應(yīng)晶體管(HFET)架構(gòu)來(lái)增強(qiáng)源極觸點(diǎn)的電子注入。研究顯示通過(guò)使用多收縮通道增加接觸的相對(duì)周長(zhǎng),可以大大減輕高接觸電阻帶來(lái)的挑戰(zhàn)。
研究人員在藍(lán)寶石上制備外延樣品,制造始于歐姆接觸的形成,接下來(lái)進(jìn)行等離子體蝕刻以創(chuàng)建臺(tái)面設(shè)備隔離。進(jìn)一步的等離子體蝕刻去除了除微通道之外的AlGaN勢(shì)壘層。蝕刻之后,用緩沖氧化物蝕刻去除硬掩模。
在10V的漏極偏置和2V的柵極電勢(shì)下,微通道器件的導(dǎo)通電阻為6.35Ω-mm,而常規(guī)HFET的柵極電壓為2V時(shí)其導(dǎo)通電阻為11.9Ω-mm。微通道晶體管的140mS / mm峰值跨導(dǎo)比傳統(tǒng)器件提高了80%。該團(tuán)隊(duì)將卓越的源電子注入~勞歸~于其出色的性能。
對(duì)于微通道和常規(guī)HFET,閾值為10mA / mm的擊穿電壓分別為80V和33V。柵極設(shè)置為-15V。相比之下,微通道設(shè)備在達(dá)到擊穿閾值之前僅變化了一個(gè)數(shù)量級(jí)。這是由于平面器件的故障主要由漏極引起的勢(shì)壘降低(DIBL)效應(yīng)決定,在微通道器件中可以抑制?3.5V的起始偏置。
由于等離子蝕刻鰭片側(cè)壁處的表面狀態(tài),微通道HFET在該范圍內(nèi)遭受高柵極漏電流擊穿。研究報(bào)告的Al0.65Ga0.35N / Al0.4Ga0.6N微通道HFET的RF輸出~率是富鋁AlGaN溝道晶體管有史以來(lái)的最高值。但是,微通道~率附加效率(PAE)僅為4%,這是由于于低~率增益和增益壓縮效應(yīng)。
原文題目:Boosting output power in aluminium gallium nitride channel transistors
原文來(lái)源:http://www.semiconductor-today.com/news_items/2020/apr/osu-090420.shtml
| 相關(guān)新聞: |
| 微電子所在新型垂直納米環(huán)柵器件研究中取得突破性進(jìn)展 |
| 金屬所等制備出柔性碳納米管傳感存儲(chǔ)一體化器件 |
| 單原子層溝道的鰭式場(chǎng)效應(yīng)晶體管問(wèn)世 |
學(xué)習(xí)園地