基于光刻過程物理模型的光刻物理仿真,可預測光刻潛像、光刻膠曝光、顯影等結果的三維形貌。相比于基于數據擬合模型的快速仿真方法,光刻物理仿真具備高精度優(yōu)勢,但低效率劣勢導致其難以對大區(qū)域掩模結構的三維光刻潛像進行快速的仿真和預測。
基于以上問題,微電子所EDA中心計算光刻團隊提出了一種基于深度學習的大區(qū)域掩模光刻潛像快速仿真方法。該方法首先建立掩模三維潛像數據庫,以訓練條件生成對抗網絡。使用訓練好的網絡計算出大區(qū)域掩模中局部位置的三維潛像,通過拼接獲得最終結果。該方法避免了大區(qū)域掩模三維潛像的直接計算,可實現(xiàn)掩模圖案到三維潛像的直接映射。仿真實驗數據表明,與嚴格求解電磁場方法相比,該方法精度達到了90%以上,速度提高了 2.5 至 4.7倍。這一成果提高了光刻三維仿真的效率,拓展了人工智能相關算法在計算光刻領域的應用。
基于本研究成果的論文LIC-CGAN: fast lithography latent images calculation method for large-area masks using deep learning近期發(fā)表在Optics Express期刊上[Optics Express, Vol. 32, Issue 23, pp. 40931-40944 (2024),DOI: 10.1364/OE. 537921],微電子所博士生趙藝涵為該文第一作者,董立松副研究員和韋亞一研究員為該文共同通訊作者。此項研究得到國家自然科學基金的項目資助。
????文章鏈接:https://doi.org/10.1364/OE.537921
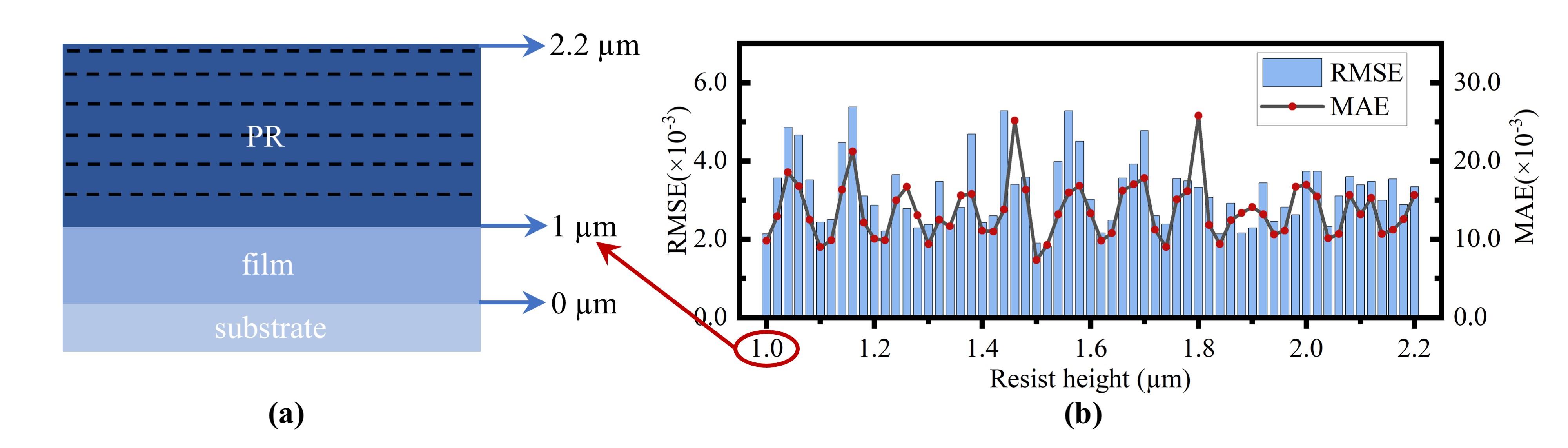
圖1.(a)光刻膠高度截面圖;
(b)在不同的光刻膠高度下測試圖案的平均均方根誤差和最大絕對誤差分布圖
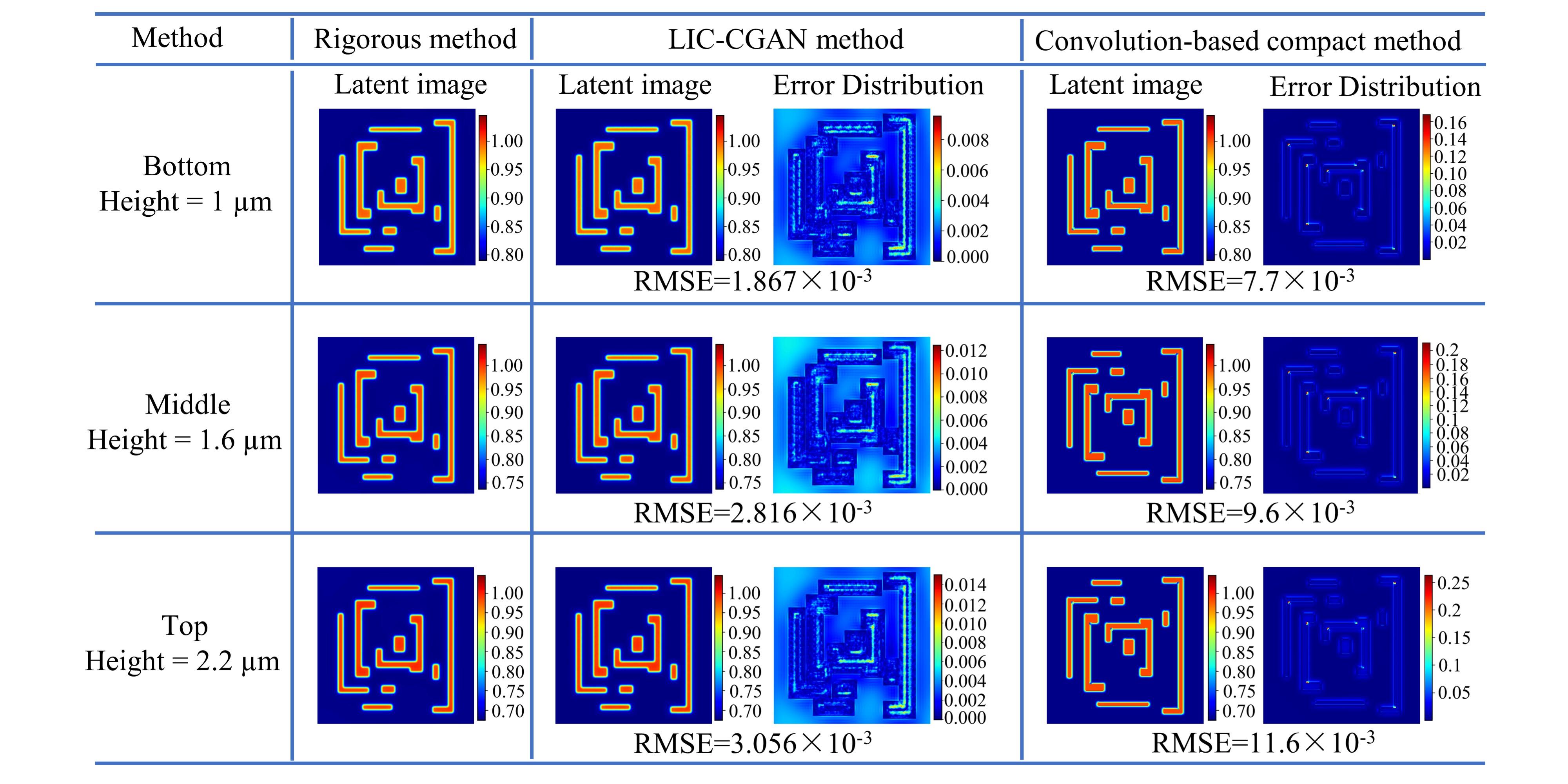
圖2. 嚴格電磁場仿真方法、論文提出方法以及基于卷積的緊湊模型在1.0um、1.6um、2.2um(對應光刻膠底部,中間和頂部)計算潛像圖和誤差分布圖
綜合信息