基于Zr摻雜HfO2(HZO)材料的鐵電存儲器有望通過后道工藝進行大規模陣列集成,但仍存在兩個關鍵的優化問題:一方面,HZO的最佳退火溫度仍高于后道工藝的熱預算限制(為保證前道工藝制備的晶體管及互聯金屬的可靠性,通常后道工藝的熱預算通常被限制在400℃以下);另一方面,對于器件在先進工藝節點中的應用,以及降低器件的寫操作功耗,需要降低HZO鐵電器件的操作電壓。
團隊通過預結晶工程,以及對TiN底電極進行預氧化處理,實現了小于8nm膜厚尺度的HZO鐵電電容器制備,器件最低可以在300℃下退火,且沒有表現出明顯的剩余極化強度退化或喚醒效應,器件的操作電壓可以降低至2V以下。優化后的器件通過后道工藝,實現了基于130nm CMOS技術的256Kbit 1T1C結構FeRAM芯片集成。由于退火溫度的降低,芯片表現出100%的初始良率。器件的耐久性超過1012,可實現超過10年的數據保持,且在2V操作電壓下芯片的功耗被降低至0.7pJ/bit。
上述成果以題“A 256 Kbit Hf0.5Zr0.5O2-based FeRAM Chip with Scaled Film Thickness (sub 8nm), Low Thermal Budget (350℃), 100% Initial Chip Yield, Low Power Consumption (0.7 pJ/bit at 2V write voltage), and Prominent Endurance (>1012)”入選2023 IEDM。微電子所姜鵬飛助理研究員為第一作者,微電子所羅慶研究員和楊建國副研究員為通訊作者。研究工作獲得基金委“后摩爾”重大專項重點支持項目和國家自然科學基金面上項目等的支持。
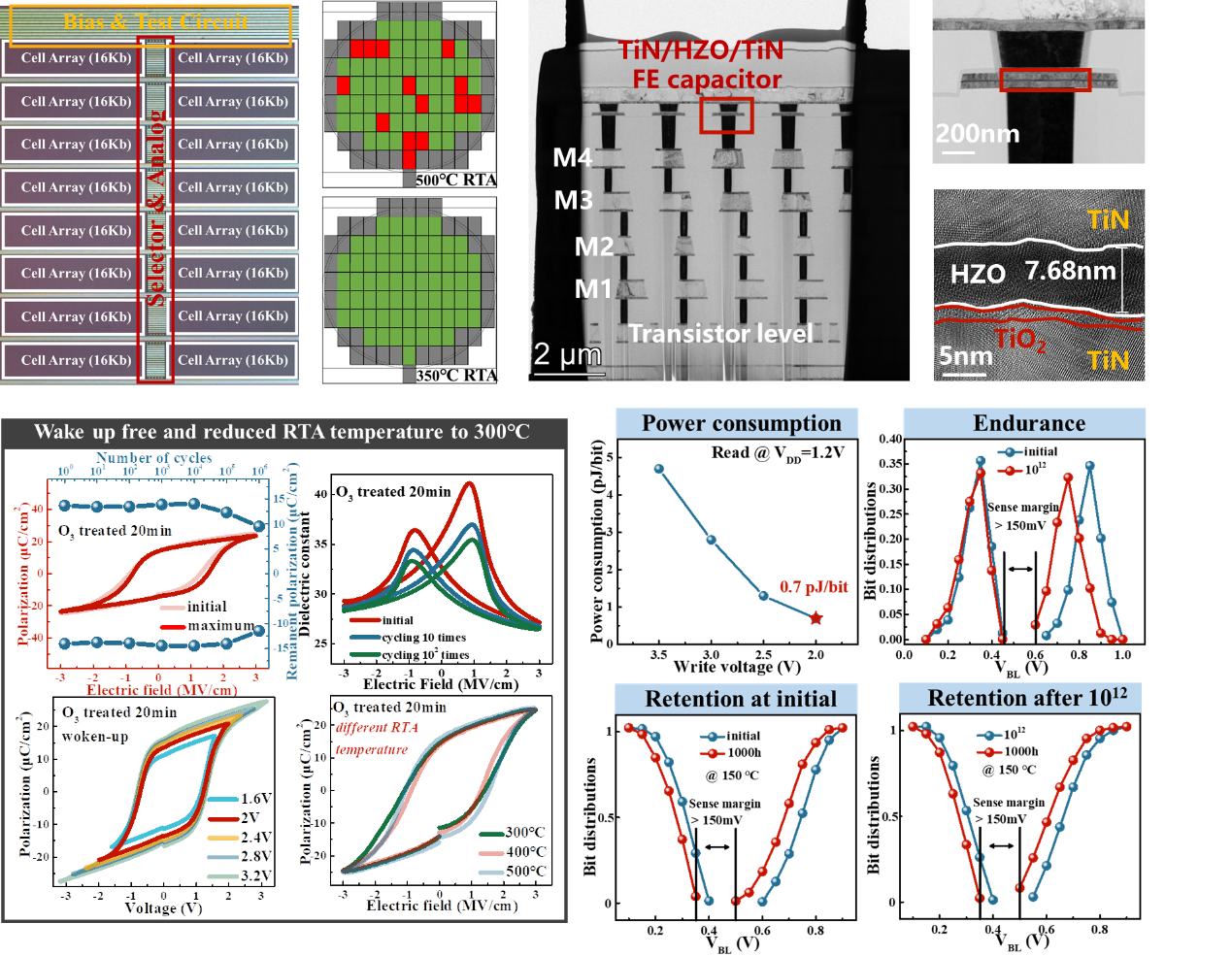
綜合信息