近日,中科院微電子所高頻高壓中心劉新宇研究員團(tuán)隊(duì)與中科院合肥物質(zhì)科學(xué)院固體物理所劉長松研究員團(tuán)隊(duì)、微電子所先導(dǎo)中心工藝平臺合作在GaN界面編輯領(lǐng)域取得了新進(jìn)展,揭示了低壓化學(xué)氣相沉積(LPCVD)SiNx/GaN界面晶化的形成機(jī)理,在理論上創(chuàng)新定義了θ-Ga2O3結(jié)構(gòu),并將1ML θ-Ga2O3薄層插入界面調(diào)控未飽和原子化學(xué)鍵,進(jìn)而有效抑制了界面帶隙電子態(tài)密度。
對于下一代平面和垂直型GaN電子器件,能否將薄膜介質(zhì)集成到III-N材料中至關(guān)重要,高質(zhì)量界面和對電應(yīng)力的高耐受性是薄膜材料選擇的主要標(biāo)準(zhǔn)和潛在挑戰(zhàn)。目前,在III-N表面已采用多種材料作為鈍化和柵極介電層以提高器件性能和可靠性,其中包括團(tuán)隊(duì)前期研究的LPCVD-SiNx介質(zhì),其具有高溫耐受性、結(jié)構(gòu)致密、無離子損傷、高TDDB特性等優(yōu)勢。但由于高沉積溫度(約780°C)和非故意氧殘留,在SiNx沉積過程中會發(fā)生復(fù)雜反應(yīng),導(dǎo)致界面處存在混合成分,包括非晶相和結(jié)晶相,甚至是不連續(xù)的產(chǎn)物。從能量角度考慮,這種扭曲的局部鍵和無序粗糙晶化物質(zhì)會導(dǎo)致帶隙中高電子態(tài)密度,進(jìn)一步導(dǎo)致意外的電流崩塌或表面泄漏電流。將無序晶化區(qū)域最小化并獲得晶態(tài)向非晶態(tài)的急劇轉(zhuǎn)變是最小化態(tài)密度的潛在方法之一。根據(jù)之前的研究結(jié)論(見[X.Y. Liu, et al. ACS Appl. Mater. Interfaces 2018, 10, 21721-21729]),LPCVD-SiNx /GaN界面之間晶化相Si2N2O形成機(jī)理與調(diào)控技術(shù)值得研究。另一方面,即使在界面上合成了完全有序的Si2N2O晶體,仍然存在較為明顯的近導(dǎo)帶態(tài)密度,需要對界面進(jìn)行原子級編輯,以期找到界面原子鍵態(tài)飽和的定量定義,從而指導(dǎo)界面態(tài)抑制工作。
本項(xiàng)研究通過深度剖析的高分辨率X射線光電子能譜技術(shù),解析了LPCVD-SiNx/GaN界面反應(yīng)物和生成物的化學(xué)成分,分析了界面部分晶化超薄層的形成機(jī)理;結(jié)合反應(yīng)吉布斯自由能變化的可行性分析,提出了一個(gè)合理的生成Si2N2O的化學(xué)反應(yīng)方程式,并認(rèn)為GaN表面高能活化的Ga2O可能有助于結(jié)晶成分的合成;創(chuàng)新定義了θ-Ga2O3結(jié)構(gòu),并將1ML θ-Ga2O3過渡層插入Si2N2O / GaN界面超胞結(jié)構(gòu)中,用于編輯界面未飽和的化學(xué)鍵。該項(xiàng)研究在理論上證明,當(dāng)界面不飽和原子的有效電荷數(shù)調(diào)整到一定區(qū)間時(shí),界面可以實(shí)現(xiàn)低態(tài)密度水平。
該工作以Partially Crystallized Ultrathin Interfaces between GaN and SiNx Grown by Low-Pressure Chemical Vapor Deposition and Interface Editing為題發(fā)表在[ACS Appl. Mater. Interfaces,2021, 13, 6, 7725–7734]期刊(DOI:10.1021/acsami.0c19483)。劉新宇研究員、黃森研究員為論文共同通訊作者,王鑫華副研究員為論文第一作者。研究得到國家自然科學(xué)基金重大儀器項(xiàng)目/重點(diǎn)項(xiàng)目/面上項(xiàng)目、中科院前沿重點(diǎn)項(xiàng)目等資助。
《ACS Appl. Mater. Interfaces》期刊服務(wù)于化學(xué)家、工程師、物理學(xué)家和生物學(xué)家的跨學(xué)科團(tuán)體,專注于如何開發(fā)和使用新發(fā)現(xiàn)的材料和界面工藝以用于特定應(yīng)用。
相關(guān)論文連接:https://pubs.acs.org/doi/10.1021/acsami.0c19483
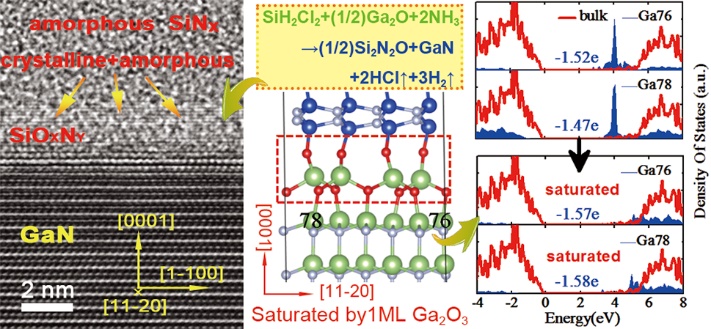
界面晶化層形成機(jī)理與原子級界面編輯
綜合信息