
 微電子所高頻高壓器件與集成研發(fā)中心劉洪剛研究員、王盛凱副研究員帶領CMOS研究團隊在國家科技重大專項02專項、國家“973”課題和國家自然科學基金等項目的支持下,對high-k/III-V、high-k/Ge界面的缺陷行為及控制方法開展了系統(tǒng)研究,經(jīng)過近5年的持續(xù)攻關,取得了突破性的研究成果。
微電子所高頻高壓器件與集成研發(fā)中心劉洪剛研究員、王盛凱副研究員帶領CMOS研究團隊在國家科技重大專項02專項、國家“973”課題和國家自然科學基金等項目的支持下,對high-k/III-V、high-k/Ge界面的缺陷行為及控制方法開展了系統(tǒng)研究,經(jīng)過近5年的持續(xù)攻關,取得了突破性的研究成果。
以InGaAs為代表的III-V族半導體材料和Ge材料具有優(yōu)異的電子和空穴遷移率,其良好的界面有利于顯著提升MOS器件的遷移率,是超高速、低功耗CMOS器件的理想溝道材料。然而,由于high-k/InGaAs、high-k/Ge的界面穩(wěn)定性較差,在界面處存在大量缺陷形成的載流子散射中心,阻礙了遷移率的提高,嚴重影響了器件的最終性能。
針對這一核心問題,CMOS研究團隊創(chuàng)新性地在high-k/InGaAs界面插入極薄外延InP層,將high-k/InGaAs的界面缺陷有效推移至high-k/InP之間。通過采用多硫化氨[(NH4)2Sx]對InP進行表面鈍化處理并結(jié)合低溫原子層高k介質(zhì)沉積技術,有效抑制了在介質(zhì)沉積以及金屬化后退火過程中的表面氧化和磷原子脫附效應,成功將high-k/InP界面的最低缺陷密度降低至2×1011 cm-2eV-1((圖1(a)),有效克服了high-k/III-VMOS電容積累區(qū)頻散這一普遍性難題,達到世界領先水平(圖1(b))。
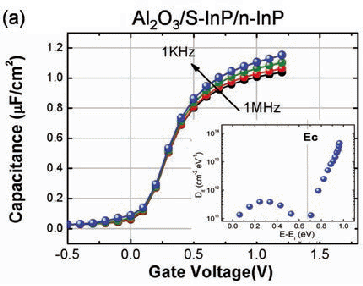
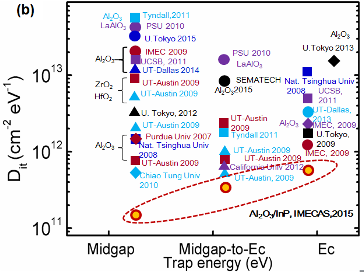
圖1.(a)采用低溫ALD工藝結(jié)合表面硫鈍化技術的high-k/InPMOS電容的電容—電壓曲線及界面態(tài)密度分布,(b)high-k/InP的界面的Dit低于2×1011cm-2eV-1,達到了世界領先水平
與III-V族溝道不同,在high-k/Ge界面適當引入GeOx層有助于降低界面缺陷密度。由于GeO在420度以上高度環(huán)境下會發(fā)生明顯的脫附現(xiàn)象,進而導致界面性能嚴重退化,因此,高溫常壓(400-550度)熱氧化方法不適合GeOx界面層的形成。CMOS研究團隊提出在原子層高k介質(zhì)沉積過程中,循環(huán)利用臭氧進行低溫(300度)原位臭氧氧化,抑制了GeO的高溫脫附,同時有效借助了高k介質(zhì)沉積過程中對臭氧分子的阻擋作用,獲得了高質(zhì)量極薄GeOx界面層。通過該方法,成功將high-k/Ge界面的最低缺陷密度降低至2×1011 cm-2eV-1以下,達到了世界先進水平(圖2),同時,光學和電學表征證實,在低溫臭氧處理過程中,介質(zhì)漏電以及介質(zhì)內(nèi)部的缺陷數(shù)量均得到有效降低,為Ge-MOS器件應用提供了解決方案。
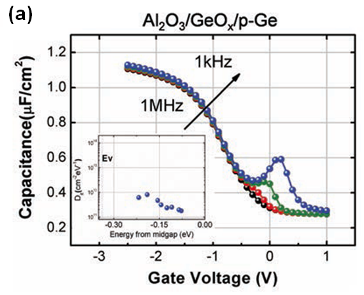
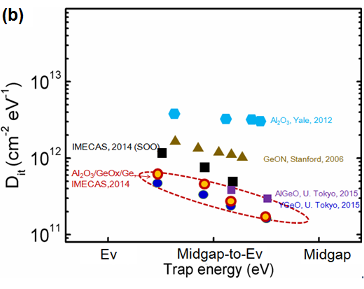
圖2.(a)采用原位循環(huán)臭氧氧化技術的high-k/GeMOS電容的電容—電壓曲線及界面態(tài)密度分布,(b)high-k/Ge界面的最低Dit低于2×1011cm-2eV-1,達到了世界先進水平
上述研究成果得到了化合物半導體領域權(quán)威雜志“Compound Semiconductor”的持續(xù)關注,王盛凱副研究員受邀為該雜志撰寫了題為“Turbo Charging the Channel”的專題文章(Feature Article),該成果發(fā)表于“Compound Semiconductor”2016年1月/2月刊(圖3)。

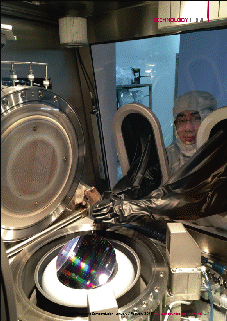
圖3.Shengkai Wang,“Turbo Charging the Channel”,“Compound Semiconductor”,January/February2016,pp.36-44.
http://www.publishing.ninja/V2/page/1839/116/6/1
綜合信息