近日,微電子所氮化鎵(GaN)功率電子器件研究團隊與香港科技大學陳敬教授團隊、西安電子科技大學郝躍院士團隊合作,在GaN增強型MIS-HEMT器件研制方面取得重要進展,成功研制出具有國際先進水平的高頻增強型GaN MIS-HEMT器件。
第三代半導體材料氮化鎵具有高禁帶寬度、高擊穿電場、高飽和電子漂移速度等優異的物理性質,尤其是材料本身的強自發和壓電極化效應能在AlGaN/GaN異質結構中誘導出高密度、高遷移率的二維電子氣(遷移率可達到2000 cm2/V·s以上),突破了傳統Si基功率器件的材料極限。這些優良性質促使GaN功率電子器件在工作頻率和電能轉換效率上脫穎而出,成為下一代高效節能功率電子器件的最佳候選之一。
增強型,也叫常關型,是電力電子應用的關鍵要求,其中柵槽刻蝕工藝是最早實現GaN增強型器件的技術之一。傳統的刻蝕工藝主要在常溫下進行,無法實現刻蝕所造成的晶格損傷的原位恢復和刻蝕殘留物的及時清除,造成器件輸出電流的急劇降低,成為制約該技術在GaN功率電子領域的應用瓶頸。微電子所GaN功率電子器件研究團隊通過耐高溫刻蝕掩模技術,創新性地采用高溫柵槽刻蝕工藝顯著降低對溝道二維電子氣的損傷,提高了刻蝕殘留物的揮發。同時采用自主研制的臭氧輔助原子層沉積技術,制備出高絕緣、低缺陷的Al2O3柵介質,有效抑制了柵極漏電流。結合以上兩項創新(如圖1所示),最終研制出閾值電壓+1.6V,脈沖輸出電流高達1.13A/mm,關態功耗僅為6×10-8 W/mm的GaN增強型MIS-HEMT器件。相對于常溫刻蝕制備的MIS-HEMT器件(輸出電流0.42A/mm),高溫刻蝕輸出電流提高了將近兩倍(如圖2(a)和(b)所示)。
該增強型MIS-HEMT器件在4GHz下的脈沖輸出功率達到5.76 W/mm,功率附加效率57%,高于國際上報道的閾值電壓超過+1.5V MIS-HEMT器件的功率性能(如圖2(c)所示)。該增強型GaN MIS-HEMT的成功研制突破了柵槽刻蝕技術制備GaN功率電子器件的瓶頸,為進一步提高氮化鎵電子器件的工作頻率(10 MHz以上)和轉換效率奠定了扎實基礎。
該項目得到國家自然科學基金和香港政府創新技術基金的資助。研究成果在半導體研究領域權威網站Semiconductor TODAY上報道并被中科院英文網站轉載,即將發表于2015年8月的IEEE Electron Device Letters(http://dx.doi.org/10.1109/LED.2015.2445353)。
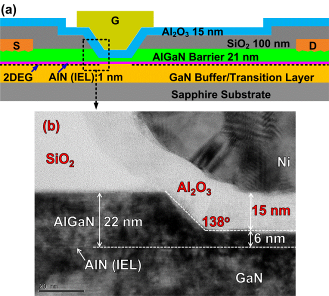
圖1 (a)研制的GaN增強型MIS-HEMT結構;(b)器件柵極TEM剖面圖
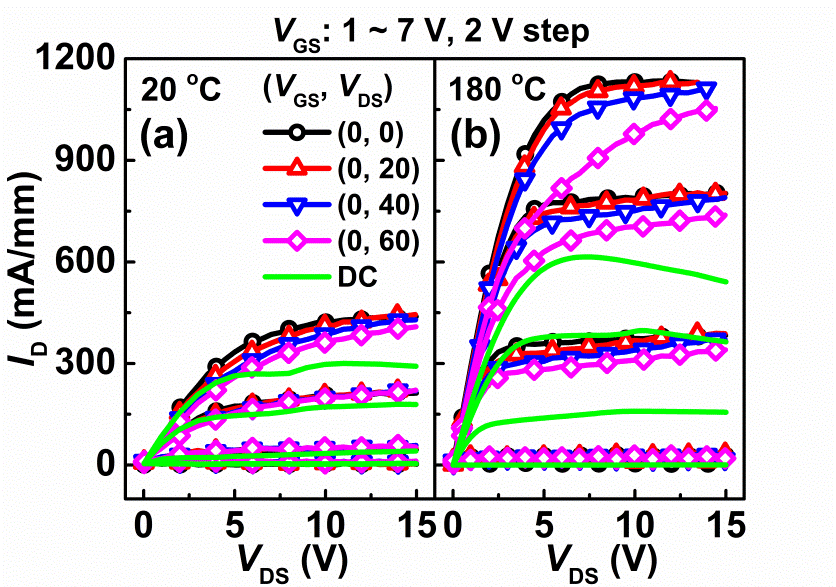
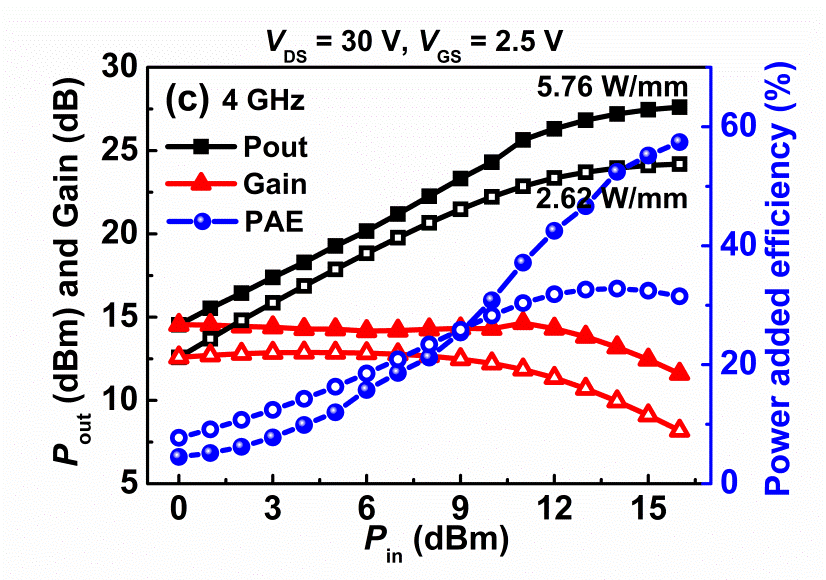
圖2 (a)常溫刻蝕MIS-HEMT器件脈沖輸出性能;(b)高溫刻蝕MIS-HEMT器件脈沖輸出性能;(c)高溫刻蝕MIS-HEMT器件RF功率性能
相關新聞鏈接:
Semiconductor TODAY: http://www.semiconductor-today.com/news_items/2015/jul/hkust_080715.shtml
Chinese Academy of Sciences: http://english.cas.cn/newsroom/research_news/201507/t20150709_150066.shtml
綜合信息