光源和掩模聯(lián)合優(yōu)化是分辨率增強技術(shù)中進一步提高光刻分辨率的關(guān)鍵技術(shù)。SMO根據(jù)光刻光學成像模型,采用預畸變方法調(diào)整光源形狀及強度分布、修正掩模圖形,調(diào)制透過掩模的電磁場分布,從而提高光刻系統(tǒng)的成像性能。基于該技術(shù),課題組與美國賽普拉斯、武漢新芯合作進行“3D-NAND存儲器關(guān)鍵層光刻條件確定”項目研發(fā),提出了新型的光源、掩模、設(shè)計規(guī)則優(yōu)化方法,進行了相應的實驗研究,不僅確保了3D-NAND典型層的成功制造,而且保證了單次曝光工藝窗口達到100納米,MEEF小于6,缺陷數(shù)量在可控范圍內(nèi),曝光結(jié)果滿足工業(yè)制造良率要求,解決了光刻工藝窗口過小的問題。
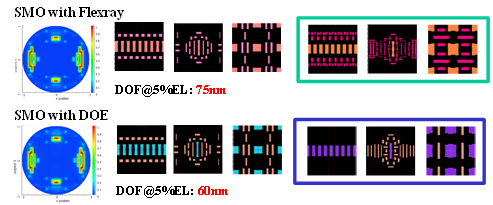
圖1. 3D-NAND VIA1光刻關(guān)鍵層SMO確定最佳光刻條件
隨著集成電路工業(yè)發(fā)展到20納米節(jié)點以下,傳統(tǒng)的設(shè)計師與制造廠之間的單線聯(lián)系已不足以支撐發(fā)展,設(shè)計和工藝聯(lián)合優(yōu)化這一新技術(shù)理念應運而生。設(shè)計與工藝聯(lián)合優(yōu)化是目前光刻技術(shù),乃至整個芯片制造技術(shù)的核心技術(shù)。標準的設(shè)計與工藝聯(lián)合優(yōu)化方法在我國仍是空白。目前該方面的研究和應用暫時處于不成熟的探索階段。課題組對10納米節(jié)點的應用開展了系統(tǒng)研究,提出了設(shè)計規(guī)則的轉(zhuǎn)換、版圖分析、模型驗證、熱點分類以及設(shè)計規(guī)則優(yōu)化等新的方法論,通過優(yōu)化設(shè)計規(guī)則生產(chǎn)適于14/10納米技術(shù)節(jié)點的友好版圖,以用于先進節(jié)點工藝探索與模型建立的研發(fā)。該研究進展被選為2016年中國半導體技術(shù)大會的邀請報告。

圖2. 10nm節(jié)點大規(guī)模隨機版圖
光刻工藝穩(wěn)定性控制是22納米及以下技術(shù)節(jié)點面臨的關(guān)鍵問題,其中焦面位置變化的高精度檢測是實現(xiàn)工藝穩(wěn)定性良好控制的重要指標。針對現(xiàn)有基于相移掩模的焦面位置檢測方法的精度無法滿足先進光刻工藝需求的問題,課題組創(chuàng)新性地在掩模測量標記的結(jié)構(gòu)中引入透光區(qū)、阻光區(qū)、180°相移區(qū)和90°相移區(qū)四種結(jié)構(gòu)(圖3)。利用優(yōu)化的四種結(jié)構(gòu)寬度比例消除了衍射級次中的+1級和+2級,順利解決了傳統(tǒng)方法在超大NA光學系統(tǒng)中靈敏度系數(shù)低的問題,成功將焦面位置檢測靈敏度提高到了![]() 。
。
相比現(xiàn)有方法,新型焦面位置測量標記將檢測靈敏度提高了25%以上。

圖3. 新型焦面位置測量標記結(jié)構(gòu)示意圖
高精度光刻套刻對準決定了核心芯片的光刻質(zhì)量。課題組就產(chǎn)業(yè)界提出的先進光刻套刻對準晶圓質(zhì)量(WQ)問題進行了攻關(guān),成功開發(fā)出面向先進光刻工藝的光刻套刻對準仿真平臺,順利解決了不同探測波長、不同薄膜圖層、不同套刻結(jié)構(gòu)對套刻WQ的影響。該仿真結(jié)果與193納米光刻機實際量測結(jié)果相符,與先進計算光刻某專用商業(yè)軟件仿真結(jié)果一致。課題組進一步采用簡化仿真算法,提出了幾種新的套刻標記(見圖4),比ASML設(shè)計的AH53和AH74衍射對準標記具有更高的第一級、第五級或第七級衍射光強,即新的設(shè)計結(jié)構(gòu)具有更高的套刻對準WQ,可獲得更可靠的晶圓套刻質(zhì)量。該成果已申請專利。

圖4. 具有更高對準精度的套刻光柵單周期精細結(jié)構(gòu)示意圖:(a)同時兼顧一級和五級衍射光強的光柵單周期精細結(jié)構(gòu);
(b)同時兼顧一級和七級衍射光強的光柵單周期精細結(jié)構(gòu)
上述研究成果得到了合作單位武漢新芯、美國賽普拉斯以及計算光刻軟件商ASML和Mentor Graphics的高度認可,為產(chǎn)業(yè)發(fā)展做出了重要貢獻。
科研工作