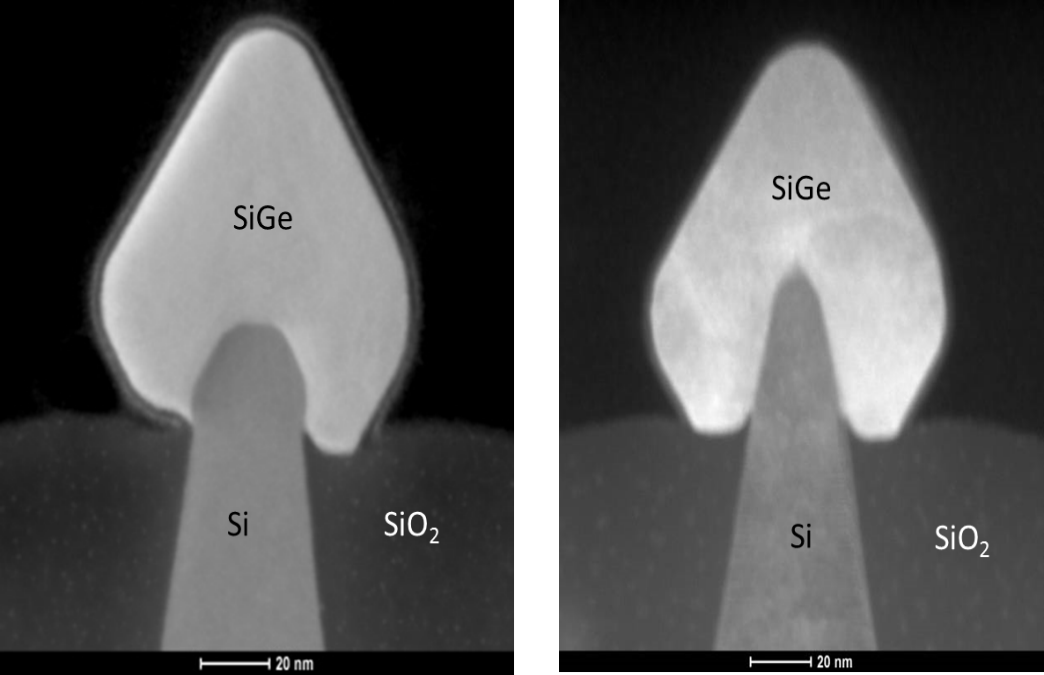
 作者信息:先導(dǎo)中心 王桂磊
作者信息:先導(dǎo)中心 王桂磊
圖片描述:本作品顯示的是用TEM電鏡檢測分析的在FinFET源漏工藝中,SiGe應(yīng)變源漏的三維選擇性外延生長。左圖中Si Fin的頂部經(jīng)過高溫烘烤后發(fā)生了Si損失和流動,選擇性外延生長的單晶SiGe并不對稱分布;右圖是在生長過程中保持了Si Fin頂部(寬度約10 nm)的形貌,選擇性生長的SiGe對稱分布在Fin的兩邊。從整體上看,Si上生長的SiGe就像是雨后從地下生長出來的“蘑菇”,煥發(fā)出生機和活力,不過這些“蘑菇”的尺寸是納米級的。
實驗方法:上圖的SiGe是通過減壓化學(xué)氣相沉積設(shè)備選擇性外延生長制備,在Fin上生長的SiGe呈三維形狀,SiO2上面沒有多晶的SiGe的生長。
樣品制備型號:FIB FEI Helios
TEM拍攝設(shè)備名稱型號:FEI Tecnai G2 F20
創(chuàng)新文化